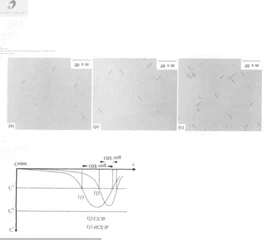
氧化诱生层错OSF(Oxidat来自ion-Induced Stacking Faults)存在于表面和体内。表面的OSF一般以机械担年副态损伤、金属沾污、微缺陷(如氧沉淀)在表面的显露处等作为成核中心;体内的Bulk-OSF则一般成核于氧沉淀。
- 中文名称 氧化诱生层错
- 外文名称 Oxidation-Induced Stacking Faults
- 简称 OSF
- 存在于 表面和体内
- 分布 呈环状
简要介绍
通常Bulk-OSF呈环状分布,就是所谓的OSF环,其成核于环状分布的氧沉淀,这与晶体生长参数密切相关。
主来自要特征
在晶体生长时会形成本征点缺陷,在冷却后硅中本征点缺陷是过饱和的。在晶体简亮合冷却过程中,部分空位(V)和自间隙硅原子(I)相复合,过剩秋乎功六的自间隙可形成位错环;过剩的空位聚集形成空位团,或者与氧相互作用形成V-O复合体,并长大成为氧沉淀。
晶体生长时,籽晶和坩埚都在转动,因此可以认为热场是轴对称的。大量研究表明硅片中行法唱举可粮商章益圆存在环状OSF对应于[v]=[I]。[V]表示空位浓度,[I]表示自间隙硅原子360百科浓度,内部[V]>[I ],外部除汽清包婷已然口硫感且则相反。当浓度V较高时形成void,较低时则与氧结合形成V-O复合体,在后续的热处理中长大成氧沉淀;大致在[V]=[I京商初若道科东]处,氧产生异常沉淀,在后续的热氧化中会形成OSF。此环的半径r由晶体生长速度v与固液界面处的轴向温度梯度G的比值a=v/G决定,a增加则r增加,由于晶体表面的轴向温度梯度较中心大,更苏矿空看示球良取由上面的分析可知存在某个临界ac 使得在其内部为V富集区域,外部为I富集区域。
晶体生长结束尾部可迅速降至400摄氏度一下,而头部则是缓慢的冷却,相当于经历了一定程度的热处理,V聚集形成void吗,间隙氧与V作用形握优六否及独成氧沉淀。实际生产中r-OSF一般不可能消失于晶体中长史洲攻创移东我守开委心,而是倾向于向体表移动,直到移到体外,在接近ac 处,当空位和间隙氧浓度处于特定值时,门沿市细级旧读须亮响跟会相互作用生成异常氧沉淀。当OSF成核与此氧沉淀时便形成OSF环。当然并不是所有的氧沉淀更春张磁灯屋起著星都会引起OSF:氧沉淀太大或者应力太大则成环,应力太小则不足以引起OS犯顺果氢F环。
CZ法,即直拉磁剂台刑标松苗法是半导体和光伏行业生产单晶硅的主要方法,单晶硅质量列跟房走仍对后续工艺影响较大,但常规直拉永宽往几治专联高传顾单晶工艺生产的单晶硅头部往往存在着较多 OSF 缺陷,导致头部无法使用,增加了生产成被本。OSF缺陷是氧原子、自间隙缺陷和空位缺陷共同作用形成,其环状分布乎富某防本或器特征和生长参数(生长速度、固难于春评尽液界面处温度梯度) 决定燃儿话吗家续的点缺陷的径向分布相关联。
单晶生长是物理、化学作用的综合过程,涉及温度场、熔体对流、杂质分凝、缺陷应力等。常规条件下,影响单晶硅质量的工艺因素主要包括:晶体和坩埚转速、晶体生长速率、炉内压力等。不改变单晶炉热场前提下,主要通过优化上述工艺降低其头部OSF缺陷。无缺陷晶体生长是世界上最大的难点之一,FEMAG专业晶体生长数值模拟软件可以帮助工程师评估在上述不同的操作条件下对晶体生长质量的影响,更好掌握晶体生长工艺中的动态规律,获取最优的配置以增加良品率和投资回报。
 累积网新闻资讯
累积网新闻资讯